直流电机驱动电路的设计目标
在直流电机驱动电路的设计中,主要考虑以下几点:
功能:电机是单向还是双向转动?需不需要调速?对于单向的电机驱动,只要用一个大功率三极管或场效应管或继电器直接带动电机即可,当电机需要双向转动时,可以使用由4个功率元件组成的H桥电路或者使用一个双刀双掷的继电器。如果不需要调速,只要使用继电器即可;但如果需要调速,可以使用三极管,场效应管等开关元件实现PWM(脉冲宽度调制)调速。

- 输出电流和电压范围,它决定着电路能驱动多大功率的电机。
- 效率,高的效率不仅意味着节省电源,也会减少驱动电路的发热。要提高电路的效率,可以从保证功率器件的开关工作状态和防止共态导通(H桥或推挽电路可能出现的一个问题,即两个功率器件同时导通使电源短路)入手。
- 对控制输入端的影响。功率电路对其输入端应有良好的信号隔离,防止有高电压大电流进入主控电路,这可以用高的输入阻抗或者光电耦合器实现隔离。
- 对电源的影响。共态导通可以引起电源电压的瞬间下降造成高频电源污染;大的电流可能导致地线电位浮动。
- 可靠性。电机驱动电路应该尽可能做到,无论加上何种控制信号,何种无源负载,电路都是安全的。
1. 输入与电平转换部分:
输入信号线由DATA引入,1脚是地线,其余是信号线。注意1脚对地连接了一个2K欧的电阻。当驱动板与单片机分别供电时,这个电阻可以提供信号电流回流的通路。当驱动板与单片机共用一组电源时,这个电阻可以防止大电流沿着连线流入单片机主板的地线造成干扰。或者说,相当于把驱动板的地线与单片机的地线隔开,实现“一点接地”。
高速运放KF347(也可以用TL084)的作用是比较器,把输入逻辑信号同来自指示灯和一个二极管的2.7V基准电压比较,转换成接近功率电源电压幅度的方波信号。KF347的输入电压范围不能接近负电源电压,否则会出错。因此在运放输入端增加了防止电压范围溢出的二极管。输入端的两个电阻一个用来限流,一个用来在输入悬空时把输入端拉到低电平。
不能用LM339或其他任何开路输出的比较器代替运放,因为开路输出的高电平状态输出阻抗在1千欧以上,压降较大,后面一级的三极管将无法截止
2. 栅极驱动部分:
后面三极管和电阻,稳压管组成的电路进一步放大信号,驱动场效应管的栅极并利用场效应管本身的栅极电容(大约1000pF)进行延时,防止H桥上下两臂的场效应管同时导通(“共态导通”)造成电源短路。
当运放输出端为低电平(约为1V至2V,不能完全达到零)时,下面的三极管截止,场效应管导通。上面的三极管导通,场效应管截止,输出为高电平。当运放输出端为高电平(约为VCC-(1V至2V),不能完全达到VCC)时,下面的三极管导通,场效应管截止。上面的三极管截止,场效应管导通,输出为低电平。
上面的分析是静态的,下面讨论开关转换的动态过程:三极管导通电阻远小于2千欧,因此三极管由截止转换到导通时场效应管栅极电容上的电荷可以迅速释放,场效应管迅速截止。但是三极管由导通转换到截止时场效应管栅极通过2千欧电阻充电却需要一定的时间。相应的,场效应管由导通转换到截止的速度要比由截止转换到导通的速度快。假如两个三极管的开关动作是同时发生的,这个电路可以让上下两臂的场效应管先断后通,消除共态导通现象。
实际上,运放输出电压变化需要一定的时间,这段时间内运放输出电压处于正负电源电压之间的中间值。这时两个三极管同时导通,场效应管就同时截止了。所以实际的电路比这种理想情况还要安全一些。
场效应管栅极的12V稳压二极管用于防止场效应管栅极过压击穿。一般的场效应管栅极的耐压是18V或20V,直接加上24V电压将会击穿,因此这个稳压二极管不能用普通的二极管代替,但是可以用2千欧的电阻代替,同样能得到12V的分压。
3.场效应管输出部分:
大功率场效应管内部在源极和漏极之间反向并联有二极管,接成H桥使用时,相当于输出端已经并联了消除电压尖峰用的四个二极管,因此这里就没有外接二极管。输出端并联一个小电容(out1和out2之间)对降低电机产生的尖峰电压有一定的好处,但是在使用PWM时有产生尖峰电流的副作用,因此容量不宜过大。在使用小功率电机时这个电容可以略去。如果加这个电容的话,一定要用高耐压的,普通的瓷片电容可能会出现击穿短路的故障。
输出端并联的由电阻和发光二极管,电容组成的电路指示电机的转动方向.
4.性能指标:
电源电压15~30 V,最大持续输出电流5A/每个电机,短时间(10秒)可以达到10A,PWM频率最高可以用到30KHz(一般用1到10KHz)。电路板包含4个逻辑上独立的,输出端两两接成H桥的功率放大单元,可以直接用单片机控制。实现电机的双向转动和调速。
5.PCB的布局布线:
大电流线路要尽量的短粗,并且尽量避免经过过孔,一定要经过过孔的话要把过孔做大一些(>1mm)并且在焊盘上做一圈小的过孔,在焊接时用焊锡填满,否则可能会烧断。另外,如果使用了稳压管,场效应管源极对电源和地的导线要尽可能的短粗,否则在大电流时,这段导线上的压降可能会经过正偏的稳压管和导通的三极管将其烧毁。在一开始的设计中,NMOS管的源极于地之间曾经接入一个0.15欧的电阻用来检测电流,这个电阻就成了不断烧毁板子的罪魁祸首。当然如果把稳压管换成电阻就不存在这个问题了。
电机驱动电路的PCB 需要采用特殊的冷却技术,以解决功耗问题。印刷电路板 (PCB) 基材(例如 FR-4 环氧树脂玻璃)的导热性较差。相反,铜的导热性非常出色。因此,从热管理角度来看,增加 PCB 中的铜面积是一个理想方案。厚铜箔(例如:2 盎司(68 微米厚))的导热性优于较薄的铜箔。然而,使用厚铜箔的成本较高,并且难以实现精细的几何形状。
因此,使用 1 盎司(34 微米)铜箔变得很常见。外层通常使用½ 盎司到1 盎司的铜箔。多层电路板内层使用的固体铜面具有良好的散热性。然而,由于这些铜面通常都置于电路板叠层的中央,因此热量会聚集在电路板内部。增加 PCB 外层的铜面积,并经由许多通孔连接或“缝接”至内层,有助于将热量转移到内层外部。
由于存在走线和元件,双层 PCB 的散热可能会更加困难。因此,尽可能多地提供固体铜面,并实现与电机驱动器 IC 的良好热连接显得非常必要。在两个外层上都增加覆铜区,并将其与许多通孔连接在一起,有助于由走线和元件分割的各区域间散热。
a、走线宽度:越宽越好
由于电机驱动器 IC 的进出电流较大(在一些情况下超过 10 A),因此应谨慎考虑进出器件的 PCB 走线宽度。走线越宽,电阻越低。必须调整走线尺寸,以使走线电阻不会消耗过多功率,避免导致走线升温。太小的走线其实可以作为电熔丝,并且容易烧断!
设计师通常使用 IPC-2221 标准来确定适当的走线宽度。这一规范针对各种电流电平和允许的温升提供了显示铜横截面积的相应图表,可转换为给定铜层厚度条件下的走线宽度。例如 1 盎司铜层中承载 10 A 电流的走线需要稍宽于 7 mm,以实现 10℃的温升。针对 1-A 电流,走线宽度只需为 0.3 mm。
鉴于此,10 A 电流似乎不可能通过微型 IC 板。
需要理解的是,IPC-2221 中建议的走线宽度适用于等宽长距离 PCB 走线。如果采用更短的PCB 走线也有可能通过更大得多的电流,且不会产生任何不良作用。这是因为短而窄的 PCB 走线电阻较小,且产生的任何热量都将被吸收至更宽的铜区域,而该区域则起到了散热片的作用。

加宽 PCB 走线,以使 IC 板能够更好地处理持续电流。
参见图中的示例。尽管该器件的 IC 板只有 0.4 mm 宽,但它们必须承载高达 3 A 的持续电流。所以我们需要尽可能地将走线加宽,并靠近器件。
走线较窄部分产生的任何热量被传导至较宽的铜区域,以使较窄走线的温升可以忽略不计。
嵌入在 PCB 内层的走线无法像外层的走线一样充分散热,因为绝缘基板的导热性不佳。为此,内层走线应设计为外层走线的约两倍宽。
作为一个大致的指导方针,下表显示了电机驱动器应用中较长走线(超过大约 2 cm)的建议走线宽度。
 如果空间允许,使用更宽走线或覆铜区的布线可使温升和压降达到最低。
如果空间允许,使用更宽走线或覆铜区的布线可使温升和压降达到最低。
b、热通孔:尽可能多地使用
通孔是小型的电镀孔,通常用于将一根走线从一层穿至另一层。虽然热通孔采用同样的方式制成,但却用于将热量从一层传至另一层。适当使用热通孔对于 PCB 的散热至关重要,但是必须考虑几个工艺性问题。
通孔具有热阻,这意味着当热量流过通孔时,通孔之间会出现一些温降,测量单位为℃/W。为使这一热阻降至最低,并提高通孔传输热量时的效率,应使用大通孔,且孔内应含有尽可能多的铜面积。
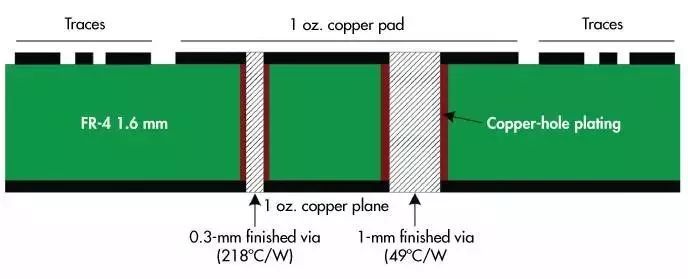
应使用大通孔(图为通孔的横截面),且孔内应含有尽可能多的铜面积,以使热阻降至最低。尽管在 PCB 的开口区域可以使用大通孔,但通孔往往置于 IC 板区域内,以直接从 IC 封装中转移热量。在这种情况下,无法使用大通孔。这是因为大型的电镀通孔可能会导致“渗锡”,即用于连接 IC 与 PCB 的焊料向下流入通孔中,从而导致焊接点质量不佳。
可以通过几种方式来减少渗锡。其中一种是使用非常小的通孔,以减少渗入到孔中的焊料量。然而,小型通孔的热阻更高,因此为实现相同的热力性能,需要更多的通孔。
另一种技术是在板的背面为通孔“搭帐篷”。这需要移除板背面阻焊层中的缺口,以使阻焊层材料盖住通孔。如果通孔较小,阻焊层将塞住通孔;因此,焊料就无法渗透 PCB。
不过,这可能会产生另外一个问题:焊剂聚集。通孔被塞住后,通孔中可能会聚集焊剂(焊膏的一种成分)。一些焊剂配方可能具有腐蚀性,如不去除,时间一长会导致可靠性问题。不过,现代大多数免清洗焊剂工艺不具有腐蚀性,且不会导致问题。
请注意,热通孔不得使用热风焊盘,它们必须直接连接至铜区域。

热通孔应直接连接PCB 上的铜区域。
建议 PCB 设计人员与表面贴装技术 (SMT) 工艺工程师一起检查 PCB 组装件,以选择适用于该组装件工艺的最佳通孔尺寸和结构,尤其是当热通孔置于 IC 板区域内时。
c、电容的布放
电机驱动器 IC 的元件布局指南与其他类型的电源 IC 类似。旁路电容器应尽可能地靠近器件电源引脚,而大容量电容器则置于其旁边。许多电机驱动器 IC 使用引导和/或电荷泵电容器,其同样应置于 IC 附近。

TSSOP 和 QFN 封装的器件底层有一个较大的外露式 IC 板。该 IC 板连接至芯片的背面,用于去除器件中的热量。该 IC 板必须充分焊接至 PCB 上,以消耗功率。
为沉积该 IC 板的焊膏而使用的模具开口并不一定会在 IC 数据表中详细说明。通常,SMT 工艺工程师对模具上应沉积多少焊料以及模具应使用何种图案有其自己的规则。
如果使用类似于 IC 板大小的单个开口,则会沉积大量焊膏。这样可能会因焊料熔化时的表面张力而导致器件被抬起。另一个问题是焊料空洞(焊料区域内的空腔或缺口)。在回流焊过程中,焊剂的挥发性成分蒸发或沸腾时,就会出现焊料空洞。这可能会导致焊料被推出焊接点。

QFN 封装的该焊料模有四个小开口,用于沉积中央IC 板上的焊膏。
SOT-23 和 SOIC 封装
 标准的引线封装(如 SOIC 和 SOT-23 封装)通常用于低功率电机驱动器中。
标准的引线封装(如 SOIC 和 SOT-23 封装)通常用于低功率电机驱动器中。为了充分提高引线封装的功耗能力,采用“倒装芯片引线框架”结构。在不使用接合线的情况下,使用铜凸点和焊料将芯片粘接至金属引线,从而可通过引线将热量从芯片传导至 PCB。
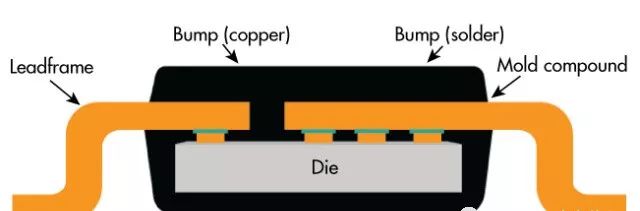
为了充分提高引线封装的功耗能力,采用“倒装芯片引线框架”结构。在不使用接合线的情况下,使用铜凸点和焊料将芯片粘接至金属引线,从而可通过引线将热量从芯片传导至 PCB。
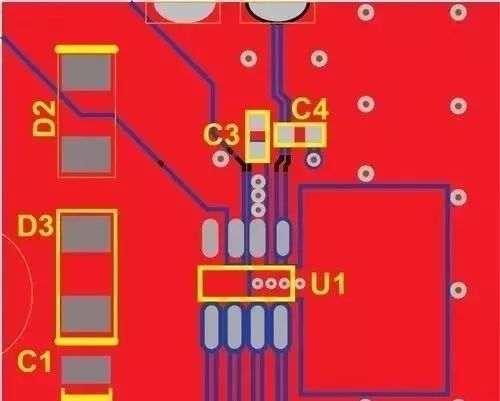
请注意,SMT 板上没有热风焊盘;它们牢牢地连接至铜区域。这对实现良好的热性能至关重要。
 QFN 和 TSSOP 封装
QFN 和 TSSOP 封装
TSSOP 封装为长方形,并使用两排引脚。电机驱动器 IC 的 TSSOP 封装通常在封装底部带有一个较大的外露板,用于排除器件中的热量。
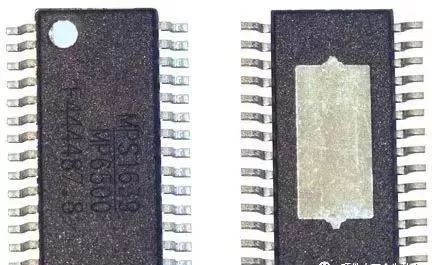
QFN 封装为无引线封装,在器件外缘周围带有板,器件底部中央还带有一个更大的板。这个更大的板用于吸收芯片中的热量。
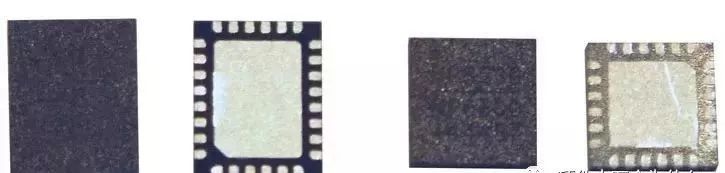 为排除这些封装中的热量,外露板必须进行良好的焊接。外露板通常为接地电位,因此可以接入 PCB 接地层。
为排除这些封装中的热量,外露板必须进行良好的焊接。外露板通常为接地电位,因此可以接入 PCB 接地层。
在理想情况下,热通孔直接位于板区域。在的 TSSOP 封装的示例中,采用了一个 18 通孔阵列,钻孔直径为 0.38 mm。该通孔阵列的计算热阻约为 7.7°C/W。

通常,这些热通孔使用 0.4 mm 及更小的钻孔直径,以防止出现渗锡。如果 SMT 工艺要求使用更小的孔径,则应增加孔数,以尽可能保持较低的整体热阻。除了位于板区域的通孔,IC 主体外部区域也设有热通孔。在 TSSOP 封装中,铜区域可延伸至封装末端之外,这为器件中的热量穿过顶部的铜层提供了另一种途径。
QFN 器件封装边缘四周的板避免在顶部使用铜层吸收热量。必须使用热通孔将热量驱散至内层或 PCB 的底层。

图中的 PCB 布局所示为一个小型的 QFN (4 × 4 mm) 器件。在外露板区域中,只容纳了九个热通孔。因此,该 PCB 的热性能不及 TSSOP 封装。
倒装芯片 QFN 封装
倒装芯片 QFN (FCQFN) 封装与常规的 QFN 封装类似,但其芯片采取倒装的方式直接连接至器件底部的板上,而不是使用接合线连接至封装板上。这些板可以置于芯片上的发热功率器件的反面,因此它们通常以长条状而不是小板状布置。

这些封装在芯片的表面采用了多排铜凸点粘接至引线框架。
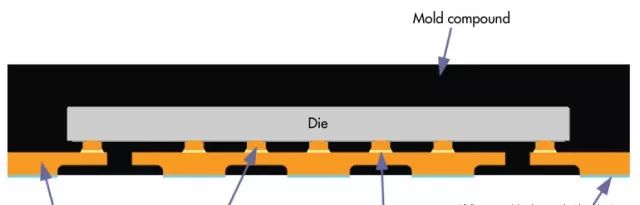
小通孔可置于板区域内,类似于常规 QFN 封装。在带有电源和接地层的多层板上,通孔可直接将这些板连接至各层。在其他情况下,铜区域必须直接连接至板,以便将 IC 中的热量吸入较大的铜区域中。
下图器件具有较长的电源和接地板,以及三个输出口。请注意,该封装只有 4 × 4 mm 大小。
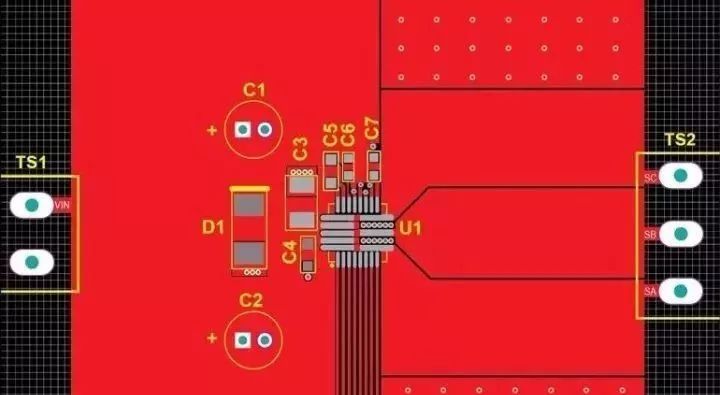
器件左侧的铜区域为功率输入口。这个较大的铜区域直接连接至器件的两个电源板。三个输出板连接至器件右侧的铜区域。注意铜区域在退出板之后尽可能地扩展。这样可以充分将热量从板传递到环境空气中。
同时,注意器件右侧两个板中的数排小通孔。这些板均进行了接地,且 PCB 背面放置了一个实心接地层。这些通孔的直径为 0.46 mm,钻孔直径为 0.25 mm。通孔足够小,适合置于板区域内。
综上所述,为了使用电机驱动器 IC 实施成功的 PCB 设计,必须对 PCB 进行精心的布局。因此,本文提供了一些实用性的建议,以期望可以帮助 PCB 设计人员实现PCB板良好的电气和热性能。
转帖自网络
