1、BGA 封装 (ball grid array)
球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用 以 代替引脚,在印 刷基板的正面装配 LSI 芯片,然后用模压树脂或灌封方法进行密封。也 称为凸 点陈列载体(PAC)。引脚可超过200,是多引脚 LSI 用的一种封装。 封装本体也可做得比 QFP(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm 的360 引脚 BGA 仅为31mm 见方;而引脚中心距为0.5mm 的304 引脚 QFP 为40mm 见方。而且 BGA 不 用担 心 QFP 那样的引脚变形问题。 该封装是美国 Motorola 公司开发的,首先在便携式电话等设备中被采用,今后在 美国有 可 能在个人计算机中普及。最初,BGA 的引脚(凸点)中心距为 1.5mm,引脚数为225。现在 也有 一些 LSI 厂家正在开发500 引脚的 BGA。 BGA 的问题是回流焊后的外观检查。现在尚不清楚是否有效的外观检查方 法。有的认为 , 由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。 美国 Motorola 公司把用模压树脂密封的封装称为 OMPAC,而把灌封方法密封的封装称为 GPAC(见 OMPAC 和 GPAC)。

2、BQFP 封装 (quad flat package with bumper)
带缓冲垫的四侧引脚扁平封装。QFP 封装之一,在封装本体的四个角设置突起(缓冲垫) 以 防止在运送过程 中引脚发生弯曲变形。美国半导体厂家主要在微处理器和 ASIC 等电路中 采用 此封装。引脚中心距0.635mm, 引脚数从84 到196 左右(见 QFP)。

3、碰焊 PGA 封装 (butt joint pin grid array)
表面贴装型 PGA 的别称(见表面贴装型 PGA)。
4、C-(ceramic) 封装
表示陶瓷封装的记号。例如,CDIP 表示的是陶瓷 DIP。是在实际中经常使用的记号。

5、Cerdip 封装
用玻璃密封的陶瓷双列直插式封装,用于 ECL RAM,DSP(数字信号处理器)等电路。带有 玻璃窗口的Cerdip
用于紫外线擦除型 EPROM 以及内部带有 EPROM 的微机电路等。引脚中 心 距2.54mm,引脚数从8 到42。在 日本,此封装表示为 DIP-G(G 即玻璃密封的意思)。

6、Cerquad 封装
表面贴装型封装之一,即用下密封的陶瓷 QFP,用于封装 DSP 等的逻辑 LSI 电路。带有窗 口的 Cerquad用 于封装 EPROM 电路。散热性比塑料 QFP 好,在自然空冷条件下可容许1. 5~ 2W 的功率。但封装成本比塑料
QFP 高3~5 倍。引脚中心距有1.27mm、0.8mm、0.65mm、 0.5mm、 0.4mm 等多种规格。引脚数从32 到368。
带引脚的陶瓷芯片载体,表面贴装型封装之一,引脚从封装的四个侧面引出,呈丁字形 。 带有窗口的用于 封装紫外线擦除型 EPROM 以及带有 EPROM 的微机电路等。此封装也称为 QFJ、QFJ-G(见 QFJ)。
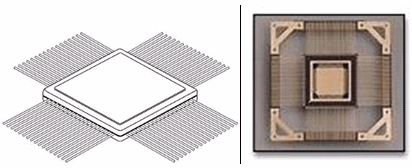
7、CLCC 封装 (ceramic leaded chip carrier)
带引脚的陶瓷芯片载体,表面贴装型封装之一,引脚从封装的四个侧面引出,呈丁字形。带有窗口的用于封装紫 外线擦除型 EPROM 以及带有 EPROM 的微机电路等。此封装也称为 QFJ、QFJ-G(见 QFJ)。

8、COB 封装 (chip on board)
板上芯片封装,是裸芯片贴装技术之一,半导体芯片交接贴装在印刷线路板上,芯片与基 板的电气连接用引线缝合方法实现,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆 盖以确保可*性。虽然 COB 是最简单的裸芯片贴装技术,但它的封装密度远不如 TAB 和倒片 焊技术。
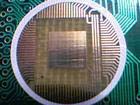
9、DFP(dual flat package)
双侧引脚扁平封装。是 SOP 的别称(见 SOP)。以前曾有此称法,现在已基本上不用。

10、DIC(dual in-line ceramic package)
陶瓷 DIP(含玻璃密封)的别称(见 DIP).

11、DIL(dual in-line) DIP 的别称(见 DIP)。欧洲半导体厂家多用此名称。

12、DIP(dual in-line package) 双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。 DIP 是最普及的插装型封装,应用范围包括标准逻辑 IC,存贮器 LSI,微机电路等。
引脚中心距2.54mm,引脚数从6 到64。封装宽度通常为15.2mm。有的把宽度为7.52mm 和10.16mm 的封 装分别称为 skinny DIP 和 slim DIP(窄体型 DIP)。但多数情况下并不加区分,只简单地统称为 DIP。另外,用低熔点玻璃密封的陶瓷 DIP 也称为 cerdip(见 cerdip)。

13、DSO(dual small out-lint)
双侧引脚小外形封装。SOP 的别称(见 SOP)。部分半导体厂家采用此名称。

14、DICP(dual tape carrier package)
双侧引脚带载封装。TCP(带载封装)之一。引脚制作在绝缘带上并从封装两侧引出。由于利用的是 TAB(自 动带载焊接)技术,封装外形非常薄。常用于液晶显示驱动 LSI,但多数为定制品。另外,0.5mm 厚的存储器 LSI簿形封装正处于开发阶段。在日本,按照 EIAJ(日本电子机械工业)会标准规定,将 DICP 命名为DTP。

15、DIP(dual tape carrier package)
同上。日本电子机械工业会标准对 DTCP 的命名(见 DTCP)。

16、FP(flat package)
扁平封装。表面贴装型封装之一。QFP 或 SOP(见 QFP 和 SOP)的别称。部分半导体厂家采用此名称。

17、Flip-chip
倒焊芯片。裸芯片封装技术之一,在 LSI 芯片的电极区制作好金属凸点,然后把金属凸点与印刷基板上 的电极区进行压焊连接。封装的占有面积基本上与芯片尺寸相同。是所有封装技术中体积最小、最薄的一种。
但如果基板的热膨胀系数与 LSI 芯片不同,就会在接合处产生反应,从而影响连接的可靠性。因此必须用树脂来加固 LSI 芯片,并使用热膨胀系数基本相同的基板材料。其中SiS 756北桥芯片采用最新的Flip-chip封装,全面支持AMD Athlon 64/FX中央处理器。支持PCI Express X16接口,提供显卡最高8GB/s双向传输带宽。支持最高HyperTransport Technology,最高2000MT/s MHz的传输带 宽。内建矽统科技独家Advanced HyperStreaming Technology,MuTIOL 1G Technology。
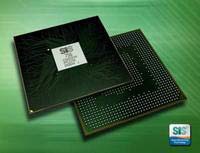
18、FQFP(fine pitch quad flat package)
小引脚中心距 QFP。通常指引脚中心距小于0.65mm 的 QFP(见 QFP)。部分导导体厂家采用此名称。塑 料四边引出扁平封装 PQFP(Plastic Quad Flat Package)PQFP 的封装形式最为普遍。其芯片引脚之间距离很小,引脚很细,很多大规模或超大集成电路都采用这 种封装形式,引脚数量一般都在100个以上。Intel 系列 CPU 中80286、80386和某些486主板芯片采用这种封装形式。 此种封装形式的芯片必须采用 SMT 技术(表面安装设备)将芯片与电路板焊接起来。采用 SMT 技术安装的芯片 不必在电路板上打孔,一般在电路板表面上有设计好的相应引脚的焊点。将芯片各脚对准相应的焊点,即可实现 与主板的焊接。用这种方法焊上去的芯片,如果不用专用工具是很难拆卸下来的。SMT 技术也被广泛的使用在芯 片焊接领域,此后很多高级的封装技术都需要使用 SMT 焊接。
以下是一颗 AMD 的 QFP 封装的286处理器芯片。0.5mm 焊区中心距,208根 I/O 引脚,外形尺寸28×28mm, 芯片尺寸10×10mm,则芯片面积/封装面积=10×10/28×28=1:7.8,由此可见 QFP 比 DIP 的封装尺寸大大减小了。

PQFP 封装的主板声卡芯片 19、CPAC(globe top pad array carrier)
美国 Motorola 公司对 BGA 的别称(见 BGA)。

20、CQFP 軍用晶片陶瓷平版封裝 (Ceramic Quad Flat-pack Package)
右邊這顆晶片為一種軍用晶片封裝(CQFP),這是封裝還沒被放入晶體以前的樣子。這種封裝在軍用品以及航太工 業用晶片才有機會見到。晶片槽旁邊有厚厚的黃金隔層(有高起來,照片上不明顯)用來防止輻射及其他干擾。 外圍有螺絲孔可以將晶片牢牢固定在主機板上。而最有趣的就是四周的鍍金針腳,這種設計可以大大減少晶片封裝的厚度並提供極佳的散熱。
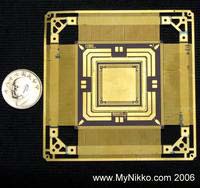
21、H-(with heat sink)
表示带散热器的标记。例如,HSOP 表示带散热器的 SOP。

22、Pin Grid Array(Surface Mount Type)
表面贴装型 PGA。通常 PGA 为插装型封装,引脚长约3.4mm。表面贴装型 PGA 在封装的 底面有陈列状的引脚,其长度从1.5mm 到2.0mm。贴装采用与印刷基板碰焊的方法,因而也称 为碰焊 PGA。因为引脚中心距只有1.27mm,比插装型 PGA 小一半,所以封装本体可制作得不 怎么大,而引脚数比插装型多(250~528),是大规模逻辑 LSI 用的封装。封装的基材有多层陶瓷基板和玻璃环氧树脂印刷基数。以多层陶瓷基材制作封装已经实用化。
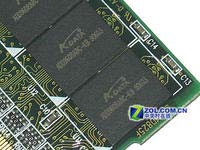
PGA 封装 威刚迷你 DDR333本内存
23、JLCC 封装(J-leaded chip carrier)
J 形引脚芯片载体。指带窗口 CLCC 和带窗口的陶瓷 QFJ 的别称(见 CLCC 和 QFJ)。部分半导体厂家 采用的名称。
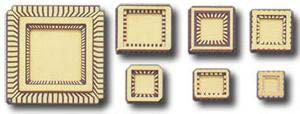
24、LCC 封装(Leadless chip carrier)
无引脚芯片载体。指陶瓷基板的四个侧面只有电极接触而无引脚的表面贴装型封装。是高速和高频 IC 用 封装,也称为陶瓷 QFN 或 QFN-C(见 QFN)。

25、LGA 封装(land grid array)
触点陈列封装。即在底面制作有阵列状态坦电极触点的封装。装配时插入插座即可。现已实用的有227 触 点(1.27mm 中心距)和447 触点(2.54mm 中心距)的陶瓷 LGA,应用于高速逻辑 LSI 电路。
LGA 与 QFP 相比,能够以比较小的封装容纳更多的输入输出引脚。另外,由于引线的阻抗小,对于高速 LSI 是很适用的。但由于插座制作复杂,成本高,现在基本上不怎么使用。预计今后对其需求会有所增加。


AMD 的2.66GHz 双核心的 Opteron F 的 Santa Rosa 平台 26、LOC 封装(lead on chip)
芯片上引线封装。LSI 封装技术之一,引线框架的前端处于芯片上方的一种结构,芯片的中心附近制作 有凸焊点,用引线缝合进行电气连接。与原来把引线框架布置在芯片侧面附近的结构相比,在相同大小的封装中容纳的芯片达1mm 左右宽度。
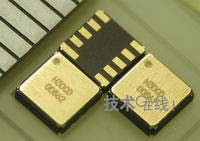
日立金属推出2.9mm 见方3轴加速度传感器
27、LQFP 封装(low profile quad flat package)
薄型 QFP。指封装本体厚度为1.4mm 的 QFP,是日本电子机械工业会根据制定的新 QFP外形规格所用的名称。

28、L-QUAD 封装
陶瓷 QFP 之一。封装基板用氮化铝,基导热率比氧化铝高7~8 倍,具有较好的散热性。 封装的框架用氧化铝,芯片用灌封法密封,从而抑制了成本。是为逻辑 LSI 开发的一种封装,在自然空冷条件下可容许 W3的功率。现已开发出了208 引脚(0.5mm 中心距)和160 引脚(0.65mm 中心距)的 LSI 逻辑用封装,并于1993 年10 月开始投入批量生产。

29、MCM封装(multi-chip module)
多芯片组件。将多块半导体裸芯片组装在一块布线基板上的一种封装。

根据基板材料可分为MCM-L,MCM-C 和MCM-D 三大类。
MCM-L 是使用通常的玻璃环氧树脂多层印刷基板的组件。布线密度不怎么高,成本较低。
MCM-C 是用厚膜技术形成多层布线,以陶瓷(氧化铝或玻璃陶瓷)作为基板的组件,与使用多层陶瓷基板的厚膜混合IC 类似。两者无明显差别。布线密度高于MCM-L。
MCM-D 是用薄膜技术形成多层布线,以陶瓷(氧化铝或氮化铝)或Si、Al 作为基板的组件。布线密谋在三种组件中是最高的,但成本也高。
30、MFP 封装( mini flat package)
小形扁平封装。塑料 SOP 或 SSOP 的别称(见 SOP 和 SSOP)。部分半导体厂家采用的名称。

31、MQFP 封装 (metric quad flat package)
按照 JEDEC(美国联合电子设备委员会)标准对 QFP 进行的一种分类。指引脚中心距为0.65mm、本体厚度 为3.8mm~2.0mm 的标准 QFP(见 QFP)。

32、MQUAD 封装 (metal quad)
美国 Olin 公司开发的一种 QFP 封装。基板与封盖均采用铝材,用粘合剂密封。在自然空冷条件下可 容许2.5W~2.8W 的功率。日本新光电气工业公司于1993 年获得特许开始生产。
33、MSP 封装 (mini square package)
QFI 的别称(见 QFI),在开发初期多称为 MSP。QFI 是日本电子机械工业会规定的名称。
34、OPMAC 封装 (over molded pad array carrier)
模压树脂密封凸点陈列载体。美国 Motorola 公司对模压树脂密封 BGA 采用的名称(见 BGA)。

35、P-(plastic) 封装
表示塑料封装的记号。如 PDIP 表示塑料 DIP。

36、PAC 封装 (pad array carrier)
凸点陈列载体,BGA 的别称(见 BGA)。

37、PCLP(printed circuit board leadless package)
印刷电路板无引线封装。日本富士通公司对塑料 QFN(塑料 LCC)采用的名称(见 QFN)。引脚中心距有0.55mm 和0.4mm 两种规格。目前正处于开发阶段。

38、PFPF(plastic flat package)
塑料扁平封装。塑料 QFP 的别称(见 QFP)。部分 LSI 厂家采用的名称。

39、PGA(pin grid array)
陈列引脚封装。插装型封装之一,其底面的垂直引脚呈陈列状排列。封装基材基本上都采用多层陶瓷基 板。在未专门表示出材料名称的情况下,多数为陶瓷 PGA,用于高速大规模逻辑 LSI 电路。成本较高。引脚中心 距通常为2.54mm,引脚数从64 到447 左右。了为降低成本,封装基材可用玻璃环氧树脂印刷基板代替。也有64~256 引脚的塑料 PGA。另外,还有一种引脚中心距为1.27mm 的短引脚表面贴装型 PGA(碰焊 PGA)。(见表面贴装型 PGA)。
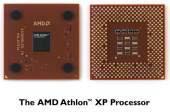
40、Piggy Back
驮载封装。指配有插座的陶瓷封装,形关与 DIP、QFP、QFN 相似。在开发带有微机的设备时用于评 价程序确认操作。例如,将 EPROM 插入插座进行调试。这种封装基本上都是定制品,市场上不怎么流通。
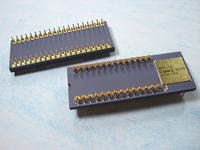

 我要赚赏金
我要赚赏金

