我们现在基本都知道,BGA封装的主要特点是在芯片底部布置了一组微小的球形金属焊盘,这些焊盘以均匀的网格状排列,与印刷电路板上的对应焊盘相连,用来连接芯片和印刷电路板。可市面上的BGA封装形式似乎多种多样,我们怎么去区分这些型号的具体分类呢?金誉半导体今天来带大家了解一下。
BGA的封装根据焊料球的排布方式可分为交错型、全阵列型、和周边型。按封装形式可分为TBGA、CBGA、FCBGA、和PBGA。以下是每个封装形式的特点和区别:
TBGA:
载带型焊球阵列,是一种较新颖的BGA封装形式。其焊接时采用低熔点焊料合金,焊料球材料为高熔点焊料合金,基板是PI多层布线基板。
有以下优点:
①为达到焊球与焊盘的对准要求,回流焊过程中利用了焊球的自对准作用印焊球的表面张力。
②封装体的柔性载带能与PCB板的热匹配性相比较。
③属经济型BGA封装。
④较PBGA,散热性能更优。

TBGA的缺点如下:
1)对湿气敏感。
2)不同材料的多级组合对可靠性产生不利的影响。
CBGA:
陶瓷焊球阵列,是历史最悠久的的BGA封装形式。其基板是多层陶瓷,为保护芯片、引线及焊盘,密封焊料将金属盖板焊接在基板上。
有以下优点:
① 较PBGA,散热性能更优。
② 较PBGA,电绝缘特性好。
③ 较PBGA,封装密度高。
④ 因其抗湿气性能高,气密性好,封装组件的长期可靠性高于其他封装阵列。

CBGA封装的缺点是:
1)由于陶瓷基板和PCB板的热膨胀系数(CTE)相差较大(A1203陶瓷基板的CTE约为7ppm/cC,PCB板的CTE约为17ppm/笔),因此热匹配性差,焊点疲劳是其主要的失效形式。
2)与PBGA器件相比,封装成本高。
3)在封装体边缘的焊球对准难度增加。
FCBGA:
倒装芯片球栅格阵列,是图形加速芯片最主要的封装格式。
有以下优点:
①解决了电磁干扰与电磁兼容的问题。
②芯片背面直接接触空气,散热效率更高。
③可提高I/O的密度,产生最佳的使用效率,因此使FC-BGA较传统封装面积缩小1/3~2/3。
基本上所有图形加速卡芯片都使用了FC-BGA封装方式,这款封装也是金誉半导体BGA封装的主要出产产品,质高价优,配送快。

FCBGA缺点如下:
1)工艺难度大
2) 成本较高等缺点
PBGA:
塑料焊球阵列封装,以塑料环氧模塑混合物为密封材料,采用BT树脂/玻璃层压板为基板。与PCB板(印刷线路板-通常为FR-4板)的热匹配性好。PBGA结构中的BT树脂/玻璃层压板的热膨胀系数(CTE)约为14ppm/℃,PCB板的约为17ppm/cC,两种材料的CTE比较接近,因而热匹配性好。有以下优点:
① 热匹配性好。
② 电性能好。
③ 熔融焊球的表面张力可以达到焊球与焊盘的对准要求。
④ 成本更低。
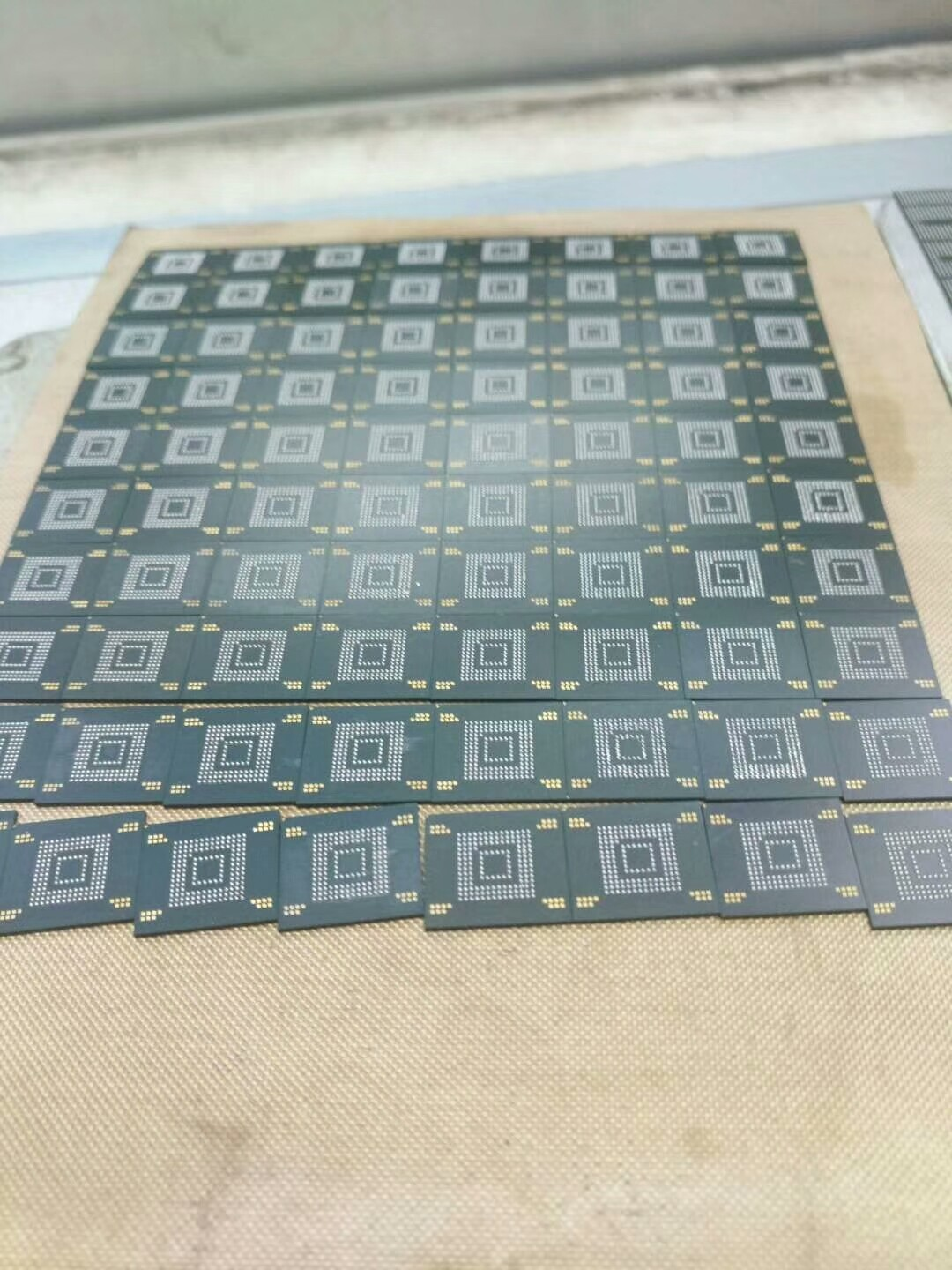
PBGA封装的缺点:
对湿气敏感,不适用于有气密性要求和可靠性要求高的器件的封装
以上是关于各类型BGA封装的优缺点,如果你有其他想法,可以在评论区告诉我们喔

 我要赚赏金
我要赚赏金

