IGBT全称为绝缘栅双极型晶体管(Insulated Gate Bipolar Transistor),所以它是一个有MOS Gate的BJT晶体管。奇怪吧,它到底是MOSFET还是BJT?其实都不是又都是。不绕圈子了,他就是MOSFET和BJT的组合体。
我在前面讲MOSFET和BJT的时候提到过他们的优缺点,MOSFET主要是单一载流子(多子)导电,而BJT是两种载流子导电,所以BJT的驱 动电流会比MOSFET大,但是MOSFET的控制级栅极是靠场效应反型来控制的,没有额外的控制端功率损耗。所以IGBT就是利用了MOSFET和BJT的优点组合起来的,兼有MOSFET的栅极电压控制晶体管(高输入阻抗),又利用了BJT的双载流子达到大电流(低导通压降)的目的 (Voltage-Controlled Bipolar Device)。从而达到驱动功率小、饱和压降低的完美要求,广泛应用于600V以上的变流系统如交流电机、变频器、开关电源、照明电路、牵引传动等领域。
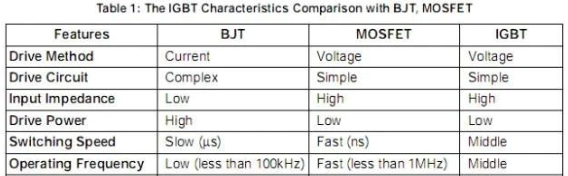
2、传统的功率MOSFET
为了等一下便于理解IGBT,我还是先讲下Power MOSFET的结构。所谓功率MOS就是要承受大功率,换言之也就是高电压、大电流。我们结合一般的低压MOSFET来讲解如何改变结构实现高压、大电流。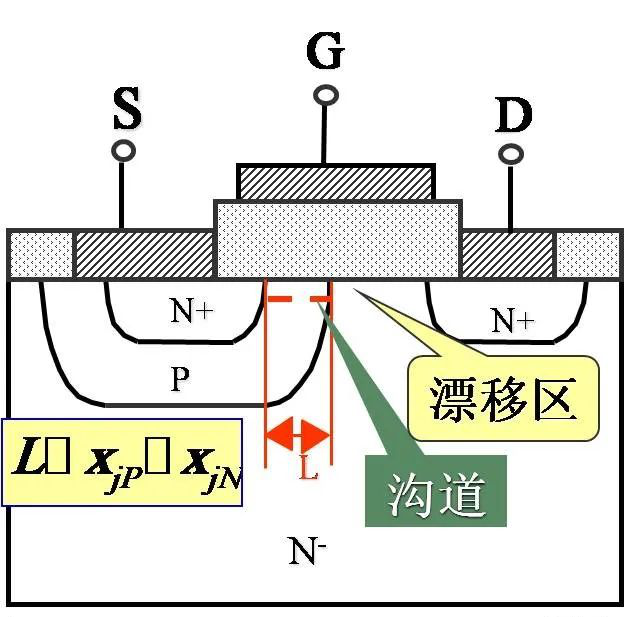
1)高电压:一般的MOSFET如果Drain的高电压,很容易导致器件击穿,而一般击穿通道就是器件的另外三端(S/G/B),所以要解决高压问题必须堵死这三端。Gate端只能靠场氧垫在Gate下面隔离与漏的距离(Field-Plate),而Bulk端的PN结击穿只能靠降低PN结两边的浓度,而最讨厌的是到Source端,它则需要一个长长的漂移区来作为漏极串联电阻分压,使得电压都降在漂移区上就可以了。
2) 大电流:一般的MOSFET的沟道长度有Poly CD决定,而功率MOSFET的沟道是靠两次扩散的结深差来控制,所以只要process稳定就可以做的很小,而且不受光刻精度的限制。而器件的电流取决于W/L,所以如果要获得大电流,只需要提高W就可以了。
所以上面的Power MOSFET也叫作LDMOS (Lateral Double diffusion MOS)。虽然这样的器件能够实现大功率要求,可是它依然有它固有的缺点,由于它的源、栅、漏三端都在表面,所以漏极与源极需要拉的很长,太浪费芯片面积。而且由于器件在表面则器件与器件之间如果要并联则复杂性增加而且需要隔离。所以后来发展了VDMOS(Vertical DMOS),把漏极统一放到Wafer背面去了,这样漏极和源极的漂移区长度完全可以通过背面减薄来控制,而且这样的结构更利于管子之间的并联结构实现大功率化。但是在BCD的工艺中还是的利用LDMOS结构,为了与CMOS兼容。
再给大家讲一下VDMOS的发展及演变吧,最早的VDMOS就是直接把LDMOS的Drain放到了背面通过背面减薄、Implant、金属蒸发制作出来的(如下图),他就是传说中的Planar VDMOS,它和传统的LDMOS比挑战在于背面工艺。但是它的好处是正面的工艺与传统CMOS工艺兼容,所以它还是有生命力的。但是这种结构的缺点在于它沟道是横在表面的,面积利用率还是不够高。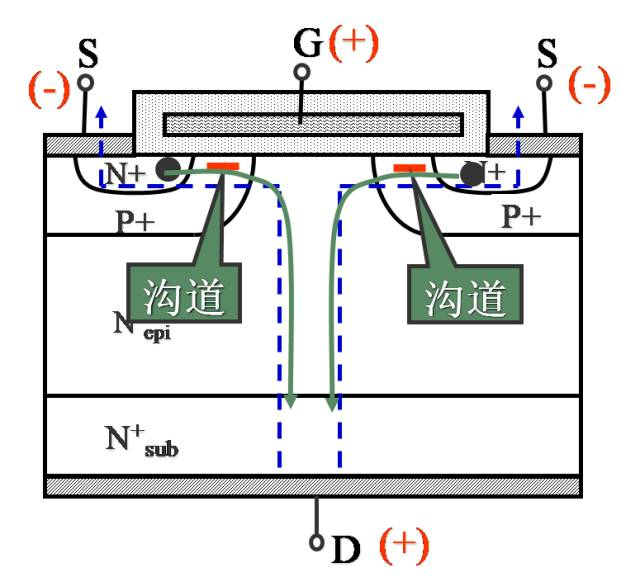
再后来为了克服Planar DMOS带来的缺点,所以发展了VMOS和UMOS结构。他们的做法是在Wafer表面挖一个槽,把管子的沟道从原来的Planar变成了沿着槽壁的 vertical,果然是个聪明的想法。但是一个馅饼总是会搭配一个陷阱(IC制造总是在不断trade-off),这样的结构天生的缺点是槽太深容易电 场集中而导致击穿,而且工艺难度和成本都很高,且槽的底部必须绝对rouding,否则很容易击穿或者产生应力的晶格缺陷。但是它的优点是晶饱数量比原来多很多,所以可以实现更多的晶体管并联,比较适合低电压大电流的application。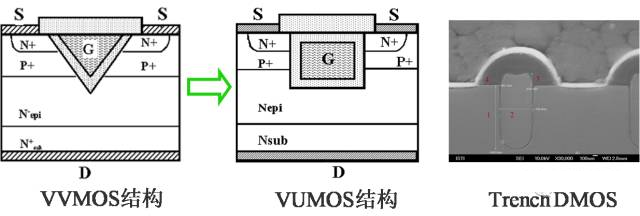
还有一个经典的东西叫做CoolMOS,大家自己google学习吧。他应该算是Power MOS撑电压最高的了,可以到1000V。
3、IGBT的结构和原理
上面介绍了Power MOSFET,而IGBT其实本质上还是一个场效应晶体管,从结构上看和Power MOSFET非常接近,就在背面的漏电极增加了一个P+层,我们称之为Injection Layer (名字的由来等下说).。在上面介绍的Power MOSFET其实根本上来讲它还是传统的MOSFET,它依然是单一载流子(多子)导电,所以我们还没有发挥出它的极致性能。所以后来发展出一个新的结 构,我们如何能够在Power MOSFET导通的时候除了MOSFET自己的电子我还能从漏端注入空穴不就可以了吗?所以自然的就在漏端引入了一个P+的injection layer (这就是名字的由来),而从结构上漏端就多了一个P+/N-drift的PN结,不过他是正偏的,所以它不影响导通反而增加了空穴注入效应,所以它的特性就类似BJT了有两种载流子参与导电。所以原来的source就变成了Emitter,而Drain就变成了Collector了。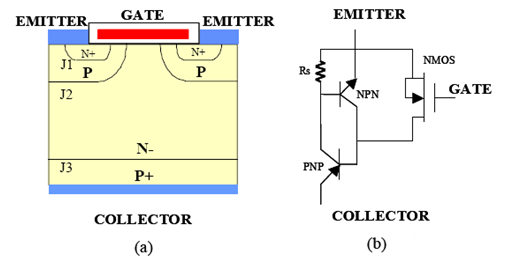
从上面结构以及右边的等效电路图看出,它有两个等效的BJT背靠背链接起来的,它其实就是PNPN的Thyristor(晶闸管),这个东西不是我们刻意做的,而是结构生成的。我在5个月前有篇文章讲Latch-up(http://ic-garden.cn/?p=511)就说了,这样的结构最要命的东西就是栓锁(Latch-up)。而控制Latch-up的关键就在于控制Rs,只要满足α1+α2<1就可以了。另外,这样的结构好处是提高了电流驱动能力,但坏处是当器件关断时,沟道很快关断没有了多子电流,可是Collector (Drain)端这边还继续有少子空穴注入,所以整个器件的电流需要慢慢才能关闭(拖尾电流, tailing current),影响了器件的关断时间及工作频率。这个可是开关器件的大忌啊,所以又引入了一个结构在P+与N-drift之间加入N+buffer层,这一层的作用就是让器件在关断的时候,从Collector端注入的空穴迅速在N+ buffer层就被复合掉提高关断频率,我们称这种结构为PT-IGBT (Punch Through型),而原来没有带N+buffer的则为NPT-IGBT。
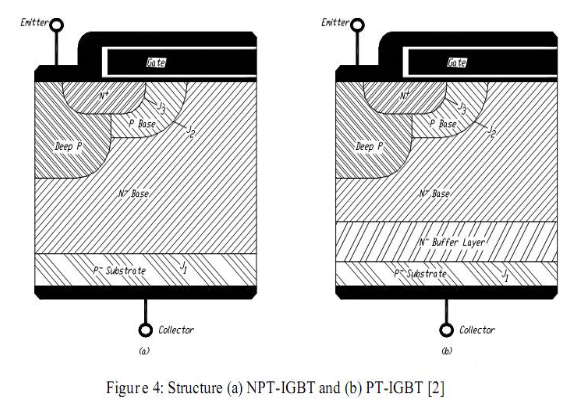
一般情况下,NPT-IGBT比PT-IGBT的Vce(sat)高,主要因为NPT是正温度系数(P+衬底较薄空穴注入较少),而PT是负温度系数(由于P衬底较厚所以空穴注入较多而导致的三极管基区调制效应明显),而Vce(sat)决定了开关损耗(switch loss),所以如果需要同样的Vce(sat),则NPT必须要增加drift厚度,所以Ron就增大了。

4、IGBT的制造工艺:
IGBT的制程正面和标准BCD的LDMOS没差,只是背面比较难搞:
1) 背面减薄:一般要求6~8mil,这个厚度很难磨了,容易碎片。2) 背面注入:都磨到6~8mil了,还要打High current P+ implant >E14的dose,很容易碎片的,必须有专门的设备dedicate。甚至第四代有两次Hi-current注入,更是挑战极限了。3) 背面清洗:这个一般的SEZ就可以。4) 背面金属化:这个只能用金属蒸发工艺,Ti/Ni/Ag标准工艺。5) 背面Alloy:主要考虑wafer太薄了,容易翘曲碎片。
5、IGBT的新技术:
1) 场截止FS-IGBT:不管PT还是NPT结 构都不能最终满足无限high power的要求,要做到high power,就必须要降低Vce(sat),也就是降低Ron。所以必须要降低N-drift厚度,可是这个N-drift厚度又受到截止状态的电场约束 (太薄了容易channel穿通)。所以如果要向降低drift厚度,必须要让截止电场到沟道前提前降下来。所以需要在P+ injection layer与N-drift之间引入一个N+场截止层(Field Stop, FS),当IGBT处于关闭状态,电场在截止层内迅速降低到0,达到终止的目的,所以我们就可以进一步降低N-drift厚度达到降低Ron和Vce了。而且这个结构和N+ buffer结构非常类似,所以它也有PT-IGBT的效果抑制关闭状态下的tailing电流提高关闭速度。
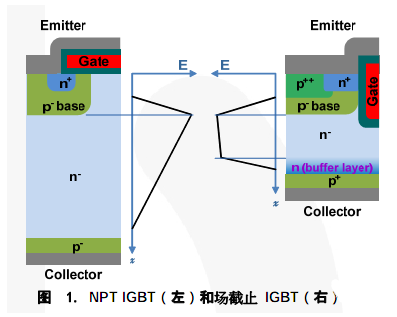
问题来了,这和PT-IGBT的N+ buffer差在哪里?其实之制作工艺不一样。PT-IGBT是用两层EPI做出来的,它是在P+ 衬底上长第一层~10um的N+ buffer,然后再长第二层~100um的N-Drift。这个cost很高啊!而相比之下的FS-IGBT呢,是在NPT-IGBT的基础上直接背面 打入高浓度的N+截止层就好了,成本比较低,但是挑战是更薄的厚度下如何实现不碎片。
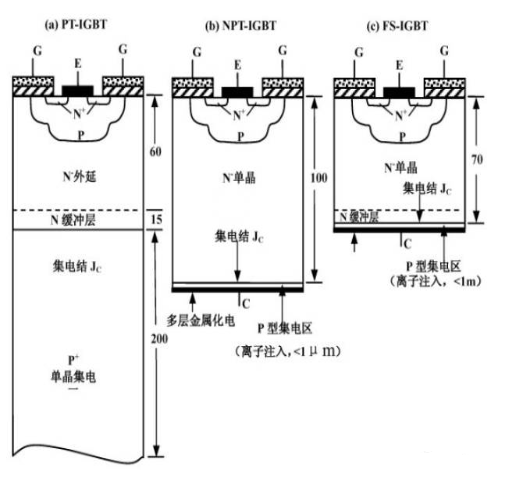
2) 阳极短接(SA: Shorted-Anode):它 的结构是N+集电极间歇插入P+集电极,这样N+集电极直接接触场截止层并用作PN二极管的阴极,而P+还继续做它的FS-IGBT的集电极,它具有增强的电流特性且改变了成本结构,因为不需要共封装反并联二极管了。实验证明,它可以提高饱和电流,降低饱和压降(~12%)。
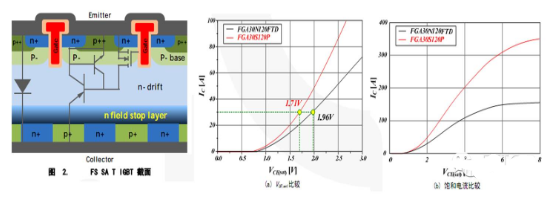
6、IGBT的主要I-V特性:
IGBT你既可以把它当做一个MOSFET与PiN二极管串联,也可以当做是一个宽基区的PNP被MOSFET驱动(Darlington结构), 前者可以用来理解它的特性,后者才是他的原理。它看起来就是一个MOSFET的I-V曲线往后挪了一段(>0.7V),因为沟道开启产生电流必须满足漂移区电流与漂移区电阻乘积超过0.7V,才能使得P+衬底与N-drift的PN结正向导通,这样才可以work,否则沟道开启也不能work的。
![]()
最后给大家吹吹牛吧,大家经常会听到第一代IGBT一直到第六代IGBT,这些是什么意思呢?
1) 第一代:他就是IGBT的雏形,最简单的原理结构图那种,所以他必须要提高N-drift来提高耐压,所以导通电阻和关断功耗都比较高,所以没有普及使用。
2) 第二代:PT-IGBT,由于耗尽层不能穿透N+缓冲层,所以基区电场加强呈梯形分布,所以可以减小芯片厚度从而减小功耗。这主要是西门子公司1990~1995年的产品BSM150GB120DN1("DN1"就是第一代的意思)。它主要在600V上有优势(类似GTR特性),到1200V的时候遇到外延厚度大成本高、且可靠性低的问题(掺杂浓度以及厚度的均匀性差)。
3)第三代:NPT-IGBT,不再采用外延技术,而是采用离子注入的技术来生成P+集电极(透明集电极技术),可以精准的控制结深而控制****效率尽可能低,增快载流子抽取速度来降低关断损耗,可以保持基区原有的载流子寿命而不会影响稳态功耗,同时具有正温度系数特点,所以技术比较成熟在稳态损耗和关断损耗间取得了很好的折中,所以被广泛采用。代表公司依然是西门子公司率先采用FZ(区熔法)代替外延的批量产品,代表产品BSM200GB120DN2,VCE>1200V, Vce(sat)=2.1V。
4)第四代:Trench-IGBT,最大的改进是采用Trench结构,是的沟道从表面跑到了垂直面上,所以基区的PIN效应增强,栅极附近载流子浓度增大,从而提高了电导调制效应减小了导通电阻,同时由于沟道不在表面,所以消除了JFET效应,所以栅极密度增加不受限制,而且在第四代IGBT继续沿用了第三代的集电极P+implant技术同时加入了第二代的PT技术作为场终止层,有效特高耐压能力等。需要使用双注入技术,难度较大。这个时候是英飞凌的时代 了,Infineon的减薄技术世界第一,它的厚度在1200V的时候可以降低到120um~140um(NPT-IGBT需要200um),甚至在600V可以降低到70um。
5)第五代:FS-IGBT和第六代的FS-Trench,第五、第六代产品是在IGBT经历了上述四次技术改进实践后对各种技术措施的重新组合。第五代IGBT是第四代产品“透明集电区技术”与“电场中止技术”的组合。第六代产品是在第五代基础上改进了沟槽栅结构,并以新的面貌出现。

目前我国的总体能源利用效率为33%左右,比发达国家低约10个百分点。当前我国节能工作面临较大压力。
根据“十一五规划”要求,到2010年中国的能源使用效率将在2005年基础上提高20%。在新能源领域,中国已成为太阳能电池生产的第一大国,风力发电的累计装机容量也连续4年实现翻番,这意味着中国新能源市场蕴藏着巨大的商机。无论是太阳能电池、风力发电还是新能源汽车,其系统应用都需要把直流电转换为交流电,承担这一任务的部件称为逆变器。逆变器的核心器件是IGBT(绝缘栅双极型晶体管),也是价格最高的部件之一,在国外,IGBT技术及产品不断更新换代,而我国目前还不具备大批量生产IGBT的能力,主要都是珠海南车、北车生产的用于高铁的IGBT技术,还有华润微电子(想收购Fairchild),还有华宏宏力貌似也有,现在国家重点扶持8寸的IGBT技术。