“随着电子产品向高密度、轻薄化和高性能方向的不断演进,作为其核心的 PCB 制造技术也面临着新的挑战与机遇。在众多工艺路线中,传统的“减成法”与新兴的“加成法”是两大核心技术路径。本文将从技术原理、成本结构到应用选型,为您提供系统性、深度的比较分析。”

1、技术原理的根本差异1.1 减成法工艺 (Subtractive Process)
加成法工艺以覆铜板为基材,通过化学蚀刻(如酸性或碱性溶液)去除不需要的铜层,从而保留设计好的电路图形。
关键步骤:
覆铜板的切割与表面处理
图形转移(贴膜、曝光、显影)
使用酸性/碱性蚀刻剂去除多余铜箔
阻焊层与字符丝印
特点:依赖铜层的“减法”来形成导电路径,需要精确控制蚀刻参数,以避免过度蚀刻或铜残留。
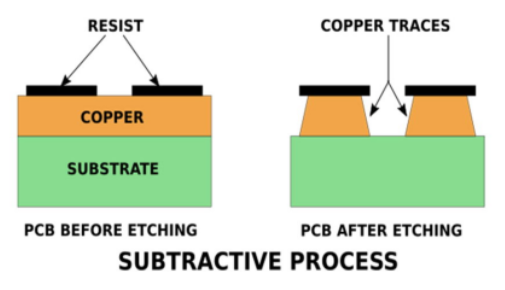 1.2 加成法工艺 (Additive Process)
1.2 加成法工艺 (Additive Process)加成法工艺在绝缘基板上直接沉积导电材料(如铜、银浆),逐层构建电路。
关键步骤:
裸基板(如聚酰亚胺、陶瓷)的预处理
选择性地应用光刻胶或电镀来沉积导电层
干燥、固化并去除多余材料
特点:无需蚀刻,可直接形成精细线路,适用于微间距和高密度设计。
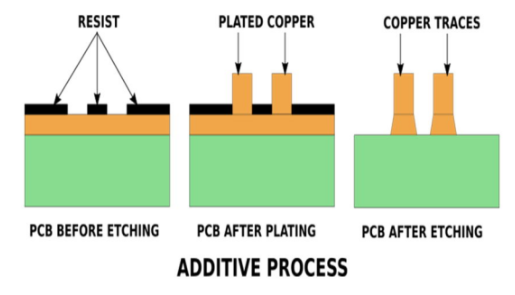 2、工艺流程对比
2、工艺流程对比步骤 | 减成法工艺 | 加成法工艺 |
材料准备 | 覆铜板(铜箔+树脂基板) | 裸基板(如聚酰亚胺薄膜) |
图形转移 | 涂覆光刻胶 → 曝光 → 显影 → 蚀刻 | 涂覆光刻胶 → 曝光 → 显影 → 电镀 |
线路形成 | 减少铜层厚度 | 增加导电材料 |
后处理 | 阻焊印刷、表面处理 (OSP/HASL) | 阻焊印刷、表面处理 (OSP/HASL) |
典型应用案例:
减成法:消费电子主板、家电控制板
加成法:柔性医疗传感器、高频微波基板
优势:
技术成熟度高:占据超过80%的市场份额,供应链完善。
大批量成本效益好:适用于单/双面板的大规模生产。
热性能优异:较厚的铜层可支持大电流应用。
局限性:
环保压力大:蚀刻废水处理成本高。
线宽/线距限制:极限约为20μm,不适用于超高密度要求。
柔性差:不适合可折叠设备。
优势:
超精细加工:线宽可低于5μm,支持IC载板级精度。
绿色制造:无铜蚀刻废物,符合RoHS/REACH标准。
适应复杂结构:可实现3D曲面和通孔电路。
局限性:
设备成本高:电镀槽、真空沉积机等设备昂贵。
材料限制:仅限于非金属基板(如陶瓷、聚合物)。
量产效率低:适用于小批量和原型制作。
固定成本:蚀刻机、曝光设备折旧(占总成本的30%)。
可变成本:
铜箔浪费:线宽越细,废料率越高(每减少0.1mm,废料率增加5%)。
蚀刻剂消耗:硝酸铁溶液成本约$5/kg,每小时用量10L。
废水处理:每平方米PCB约$0.8。
案例分析:
生产1㎡的4层FR4板(100μm线宽):
材料成本:$12
加工成本:$8(含蚀刻、钻孔)
总成本:$20
固定成本:电镀设备、洁净室维护(占总成本的45%)。
可变成本:
导电材料:纳米银浆$50/g,每层0.1g。
能源消耗:电镀槽功率5kW,运行成本$0.15/h。
良率损失:复杂结构良率约75%(减成法为92%)。
案例分析:
生产1㎡的6层陶瓷基板(20μm线宽):
材料成本:$35
加工成本:$18(含溅射、电镀)
总成本:$53
成本盈亏平衡点分析:
对于大于500㎡的批量订单,减成法成本低35%。对于小批量(<100㎡),加成法溢价可达200%。
场景 | 推荐工艺 | 关键理由 |
消费电子主板 | 减成法 | 大批量、低成本、技术成熟 |
5G基站高频PCB | 加成法 | 低介电损耗,支持毫米波频率 |
可穿戴设备柔性电路 | 加成法 | 弯折次数 > 10万次,厚度 < 0.1mm |
汽车控制模块 | 减成法 | 耐高温(150°C),抗振动 |
半导体封装基板 | 加成法 | 线宽/线距 ≤50μm,支持TSV三维封装 |
军工/航空高可靠性PCB | 减成法 | 通过MIL-STD-883认证 |
6、未来技术趋势6.1 减成法工艺创新
激光直接成型 (LDS):通过激光激活实现选择性镀铜。
绿色蚀刻剂:采用无硝酸盐的过硫酸钠体系,减少污染。
卷对卷 (R2R) 生产:实现柔性基板的连续制造。
3D打印导电油墨:纳米银/铜颗粒直接写入,精度可达10μm。
减材-增材结合:主线路用减成法,微通孔用加成法。
金属有机化学气相沉积 (MOCVD):在基板上生长铜纳米线网络。

 我要赚赏金
我要赚赏金

